
@fluketw

| 2020。03 30 | SiC 單晶 PVT 工藝紅外線測溫解決方案 |
|---|
SiC 單晶 PVT 工藝紅外線測溫解決方案

我們致力於為寬禁帶半導體材料客戶提供精準的測溫方案
PVT 工藝中準確控溫的重要作用

目前實現商業化的 SiC 單晶生產以 PVT (Physical Vapor Tra nsport) 法為主,主要是通過加熱 SiC 多晶粉末使其昇華, 之後在坩堝上部籽晶處結晶的方式製備 SiC 單晶 (4H-SiC,6H-SiC)。在 PVT 技術中, 多型共生缺陷是影響單晶質量的重要因素, 而準確的溫度控制是晶型控制的基礎,SiC 多型和溫度的關係如下圖所示:
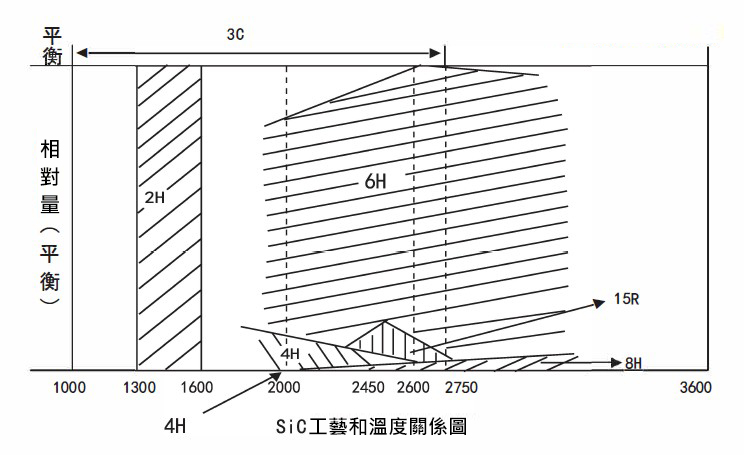
從 SiC 工藝和溫度的關係圖中可以看出,單晶的製備過程需要控制在 2000 度以上, 且為了準確控制晶型,溫度精度應該越高越好。但由於單晶結晶溫度很高, 且測量過程中不斷有污染物干擾測溫視場,造成 PVT 工藝準確測溫、控溫及保持量產工藝溫度一致性的難度極大。
高精度雙色測溫儀 E1RH 在 PVT 工藝中的應用
針對這種工況,FLUKE 開發了 Endurance E1RH 影像瞄準高精度雙色紅外線測溫儀,其在具有行業領先的系統精度的同時,集成了影像瞄準,衰減警報等針對性功能,幫助 SiC 單晶客戶確保測溫準確,控制量產工藝溫度的一致性。
下圖為 E1RH 在碳化矽單晶生產中實際測溫效果,可以清楚的看到用 E1RH 有以下優點:

1. 直覺的影像瞄準幫助實現精準瞄準,降低目鏡瞄準的人為瞄準誤差,保持量產每爐之間的瞄準一致性。
2. 監控測溫視場污染程度,結合衰減警報及現場工藝控溫要求,可以在測溫精度下降時及時警報。
3. 遠距離係數配合高精度,E1RH 在連接長度 1000m / 直徑 2mm 的光纖電纜條件下,測量 2000°C 時的測溫誤差可以控制在 ±12°C 以內。


